Question: Study the excerpt from this Micron data flyer (2012, p. 1). Describe the designers use of alignment as a design principle. How effective is it?
Study the excerpt from this Micron data flyer (2012, p. 1). Describe the designer’s use of alignment as a design principle. How effective is it? How would you modify it? Present your analysis and recommendations in a brief memo to your instructor.
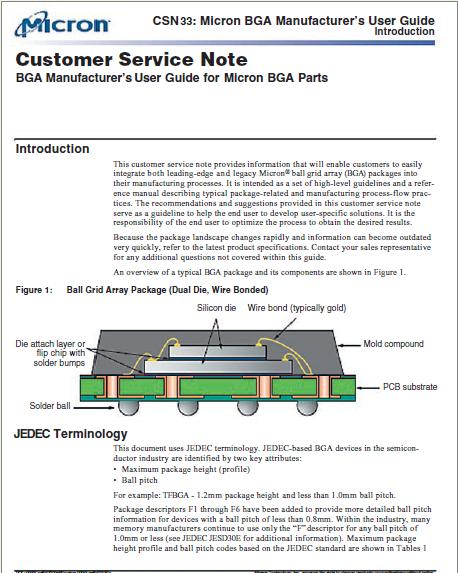
Micron CSN 33: Micron BGA Manufacturer's User Guide Introduction Customer Service Note BGA Manufacturer's User Guide for Micron BGA Parts Introduction This customer service note provides information that will enable customers to easily integrate both leading-edge and legacy Micron ball grid array (BGA) packages into their manufacturing processes. It is intended as a set of high-level guidelines and a refer- ence manual describing typical package-related and manufacturing process-flow prac- tices. The recommendations and suggestions provided in this customer service note serve as a guideline to help the end user to develop user-specific solutions. It is the responsibility of the end user to optimize the process to obtain the desired results. Because the package landscape changes rapidly and information can become outdated very quickly, refer to the latest product specifications. Contact your sales representative for any additional questions not covered within this guide. An overview of a typical BGA package and its components are shown in Figure 1. Figure 1: Ball Grid Array Package (Dual Die, Wire Bonded) Silicon die Wire bond (typically gold) Die attach layer or flip chip with solder bumps Mold compound PCB substrate Solder ball JEDEC Terminology This document uses JEDEC terminology. JEDEC-based BGA devices in the semicon- ductor industry are identified by two key attributes: Maximum package height (profile) Ball pitch For example: TFBGA - 1.2mm package height and less than 1.0mm ball pitch. Package descriptors F1 through F6 have been added to provide more detailed ball pitch information for devices with a ball pitch of less than 0.8mm. Within the industry, many memory manufacturers continue to use only the "F"descriptor for any ball pitch of 1.0mm or less (see JEDEC JESD30E for additional information). Maximum package height profile and ball pitch codes based on the JEDEC standard are shown in Tables 1
Step by Step Solution
There are 3 Steps involved in it

Get step-by-step solutions from verified subject matter experts


